В наногетероструктурах InAlAs/InGaAs/InAlAs, выращенных на подложках фосфида индия, можно создать двумерные электроны с высокой концентрацией более 1012 см–2, высокой подвижностью, высокой дрейфовой скоростью насыщения при комнатной температуре [1–3]. Данные структуры широко применяются для создания СВЧ устройств [4, 5]. Частота работы такого прибора f = Vд.н./Lg определяется дрейфовой скоростью насыщения Vд.н. и длиной затвора Lg. При этом сейчас возможно создать транзисторы с длиной затвора Lg ~ 25 нм, что близко к предельно возможной. Поэтому для увеличения рабочей частоты необходимо увеличение дрейфовой скорости электронов. Это возможно либо выбором полупроводников для создания гетероструктур, либо определенной конструкцией квантовой ямы.
Решеточно-согласованные (изоморфные) с подложкой InP квантовые ямы InyAl1-yAs/InxGa1-xAs/InyAl1-yAs обладают высоким содержанием индия х = 0,53. В квантовых ямах AlyGa1-yAs/InxGa1-xAs на подложках GaAs содержание индия ограничено величиной х = 0,2 [6]. Увеличение содержания индия необходимо для уменьшения эффективной массы электронов, так как в InAs эффективная масса электронов меньше, чем в GaAs. Однако существуют причины, препятствующие уменьшению эффективной массы двумерных электронов в квантовой яме и увеличению электронной подвижности за счет увеличения содержания индия. Это различные механизмы рассеяния в сложных многослойных гетеросистемах [7]. Поэтому разработка конструкции квантовой ямы, например, содержания индия в квантовой яме, наличие вставок различного состава в яму и исследование их влияния на подвижность электронов в квантовой яме является актуальной задачей.
Можно изменять профиль дна зоны проводимости, то есть делать различные вставки в основную квантовую яму, например, узкие, туннельно-прозрачные барьеры [8, 9], что изменяет фононный спектр и электронную подвижность. А можно вставлять в основную квантовую яму узкие более глубокие квантовые ямы [10]. Введение InAs в квантовую яму, с одной стороны, увеличивает электронную подвижность m за счет ослабления межподзонного рассеяния электронов и уменьшения эффективной массы электронов т* в квантовой яме. С другой стороны, увеличение толщины вставленного слоя InAs ограничено критическим значением, превышение которого приводит к ухудшению качества вставки и всей активной области из-за образования дислокаций несоответствия.
В настоящей работе изучалось влияние вставок InAs различной толщины на подвижности электронов в согласованных по параметру решеток квантовых ямах In0,53Ga0,47As на подложках InP. Использовался эффект Шубникова–де Гааза квантовых осцилляций магнетосопротивления. Проводились расчеты зонных диаграмм структур, квантовых и транспортных подвижностей в подзонах размерного квантования.
Материалы и методы исследований
Для изучения влияния вставок в канал на подвижности носителей заряда в настоящей работе была использована серия из 4-х образцов с изоморфной к подложке InP квантовой ямой In0,53Ga0,47As со вставками InAs различной толщины в центр ямы. Структура слоёв образцов схематически изображена на рис. 1. Образцы 2 и 3, в отличие от образца 1, содержат вставку InAs в квантовой яме, квантовая яма образца 4 состоит только из InAs. Образцы 1–3 дельта-легированы кремнием с двух сторон, образец 4 – с одной стороны.
|
In0,53Ga0,47As 54 Å |
|
In0,52Al0,48As 173 Å |
|
δ-Si 2,9·1012 см-2 |
|
In0,52Al0,48As 47 Å |
|
In0,53Ga0,47As (147 Å ‒ d)/2 |
|
InAs d |
|
In0,53Ga0,47As (147 Å ‒ d)/2 |
|
In0,52Al0,48As 47 Å |
|
Δ ‒ Si 0,88·1012 см-2 |
|
In0,52Al0,48As 2440 Å |
|
InP (100) |
Рис. 1. Структура слоёв образцов (серым выделена квантовая яма)
В табл. 1 приведены некоторые параметры образцов, а именно толщина слоя InAs d, концентрация NHall и подвижность μHall, полученные из эффекта Холла при 4,2 К и концентрации электронов NSdH в двух подзонах размерного квантования, полученные из эффекта Шубникова–де Гааза.
Таблица 1
Толщина слоя InAs d в центре квантовой ямы шириной L, концентрация NHall и подвижность μHall, полученные из эффекта Холла при 4,2 К и из эффекта Шубникова – де Гааза NSdH в двух подзонах
|
№п/п |
L, Å |
d, Å |
NHall, 1012 см–2 |
μHall, см2/(В.с) |
NSdH, 1012 см–2 |
|
1 |
147 |
0 |
4,03 |
27600 |
2,76; 1,29 |
|
2 |
147 |
18 |
2,99 |
21600 |
2,3; 0,75 |
|
3 |
147 |
31,4 |
3,03 |
29500 |
2,44; 0,6 |
|
4 |
97 |
97 |
1,30 |
28400 |
1,29 |
У всех образцов были исследованы температурные зависимости сопротивления в интервале температур 4,2–300 К, эффект Холла и эффект Шубникова–де Гааза при температуре 4,2 К в магнитных полях до 6 Тл, создаваемых сверхпроводящим соленоидом.
Результаты исследований и их обсуждение
На рис. 2 представлены зависимости сопротивления на квадрат от температуры ρxx(T) для исследованных образцов. При понижении температуры сопротивление уменьшается и показывает преимущественное рассеяние электронов на акустических фононах в этой области температур. При низких температурах рассеяние на фононах сменяется рассеянием на ионизированных примесях.

Рис. 2. Зависимости сопротивления на квадрат ρxx(T) от температуры для исследованных образцов. Цифры у кривых соответствуют номерам образцов в таблице 1
Во всех образцах при Т = 4,2 К наблюдались осцилляции магнетосопротивления (эффект Шубникова–де Гааза) В качестве примера на рис. 3 приведены осцилляции Шубникова–де Гааза, их Фурье-спектры и осцилляции холловского сопротивления для образца 1.
По графикам зависимостей сопротивления ρxx(B) от магнитной индукции B видно, что у данных структур (кроме образца 4) наблюдаются две частоты Шубникова–де Гааза, то есть заполнены две подзоны размерного квантования. Были определены частоты и по ним концентрации электронов NSdH (см. табл. 1). По зависимостям холловского сопротивления от магнитной индукции ρxy(B) были рассчитаны холловские концентрации NHall и подвижности μHall двумерных электронов. Эти величины также приведены в табл. 1, из которой видно, что сумма концентраций электронов в первой и второй подзонах, полученных из эффекта Шубникова–де Гааза, и концентрации, полученной из эффекта Холла, совпадают для всех образцов. Значение подвижности электронов у структуры с более широкой вставкой увеличилось по сравнению со значением подвижности у структуры без вставки и с узкой вставкой InAs. Подвижности электронов у образца с квантовой ямой (состоящей только из InAs) и образца с квантовой ямой InGaAs без вставки близки. То есть подвижность носителей заряда зависит от ширины вставки в квантовой яме, и она максимальна для вставки InAs шириной 31,4 Å.

Рис. 3. Зависимость магнетосопротивления ρxx(B), холловского сопротивления ρxy(B) от магнитного поля B, Фурье-спектр осцилляций (вставка).
Расчёт зонной структуры, волновых функций, квантовой и транспортной подвижностей электронов
Методом самосогласованного решения уравнения Шрёдингера и уравнения Пуассона в приближении эффективной массы были получены профиль дна зоны проводимости, уровни энергии и волновые функции электронов. Метод расчёта и используемые параметры приведены в работах [11–13]. На рис. 4 представлены результаты расчётов для образца 3 с оптимальной шириной центральной вставки InAs. Как видно из рис. 4, действительно ниже уровня Ферми в квантовой яме находится два уровня размерного квантования. Наличие центральной вставки InAs в квантовую яму приводит к тому, что уровень размерного квантования E1 опускается ближе ко дну квантовой ямы. Он в основном формируется вставкой. Эффективная ширина квантовой ямы, определяемая полушириной волновой функции, уменьшается. Расстояние между первым E1 и вторым E2 уровнями энергии возрастает. Это приводит к увеличению электронной подвижности за счет ослабления межподзонного рассеяния. В то же время возрастает рассеяние на неоднородностях бокового рельефа, что несколько понижает подвижность. Но в целом при оптимальной толщине вставки подвижность электронов возрастает. Вставка InAs сжата по сравнению с изоморфными слоями In0.53Ga0.47As. Существует предельная ширина такой вставки, выше которой появятся дефекты. Как видно из табл. 1, максимальная электронная подвижность наблюдается в образце 3 со вставкой InAs в квантовой яме шириной 31,4 Å.
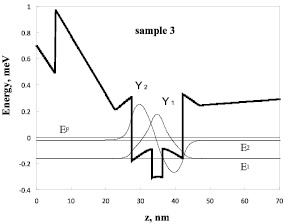
Рис. 4. Профиль дна зоны проводимости, уровни энергии и волновые функции электронов для образца 3. Энергия отсчитывается от уровня Ферми EF, E1 и E2 – уровни размерного квантования
Одним из важных методов изучения механизмов рассеяния электронов в квантовых ямах является исследование транспортного tt и квантового tq времен рассеяния электронов или квантовой  и транспортной
и транспортной  подвижностей электронов [11–13]. Обе подвижности могут быть найдены либо из осцилляционной зависимости продольного магнетосопротивления в квантующем магнитном поле – эффекта Шубникова–де Гааза, либо прямыми расчетами [11–13]. При этом отношение μt/μq позволяет определить доминирующий характер рассеяния, определяющий электронную подвижность в квантовой яме. В одиночной квантовой яме AlGaAs/GaAs преобладает малоугловое рассеяние и μt/μq ~ 10 – 100. В гетероструктурах InAlAs/InGaAs на подложках InP, в основном, преобладает рассеяние на флуктуациях состава сплава и обычно μt/μq ≥ 1.
подвижностей электронов [11–13]. Обе подвижности могут быть найдены либо из осцилляционной зависимости продольного магнетосопротивления в квантующем магнитном поле – эффекта Шубникова–де Гааза, либо прямыми расчетами [11–13]. При этом отношение μt/μq позволяет определить доминирующий характер рассеяния, определяющий электронную подвижность в квантовой яме. В одиночной квантовой яме AlGaAs/GaAs преобладает малоугловое рассеяние и μt/μq ~ 10 – 100. В гетероструктурах InAlAs/InGaAs на подложках InP, в основном, преобладает рассеяние на флуктуациях состава сплава и обычно μt/μq ≥ 1.
Транспортную подвижность можно рассчитать в рамках кинетического уравнения, рассматривая рассеяние на примесях в борновском приближении. Для нескольких заполненных подзон теория обобщена в [14] (см. также ссылки [11–13]). Результаты расчетов представлены в табл. 2. Как видно из сравнения обеих подвижностей, транспортная подвижность существенно превышает квантовую, что свидетельствует о преобладающем характере малоуглового рассеяния, характерного для рассеяния электронов на ионизированной примеси. Как видно из рис. 4, это связано с тем, что волновые функции электронов заходят в дельта слои легирующего кремния. Вторая особенность – расчетные подвижности превышают наблюдаемые экспериментально. Это в первую очередь связано с тем, что в расчетах не учтены дополнительные механизмы рассечяния в структурах со вставками, например рассеяние на латеральных неоднородностях.
Таблица 2
Квантовая μq и транспортная μt подвижности для первой и второй подзон размерного квантования
|
№ п/п |
Номер подзоны |
μq, см2/(В.с) |
μt, см2/(В.с) |
|
1 |
2 |
1600 |
108000 |
|
1 |
2300 |
90100 |
|
|
2 |
2 |
800 |
22300 |
|
1 |
5700 |
271000 |
|
|
3 |
2 |
800 |
19000 |
|
1 |
5400 |
337000 |
|
|
4 |
1 |
1700 |
243000 |
Заключение
В работе были исследованы электронные подвижности в изоморфных квантовых ямах In0.53Ga0.47As с центральной вставкой InAs различной толщины на подложках InP. Максимальная подвижность электронов наблюдается при ширине вставки d = 31,4 Å. Измерены и рассчитаны подвижности электронов в подзонах размерного квантования. Показано, что рассеяние на ионизированных примесях играет существенную роль в исследованных структурах.
Авторы благодарят Г.Б. Галиева, Е.А. Климова и И.С. Васильевского за предоставление образцов.
Рецензенты:
Константинова Е.А., д.ф.-м.н., профессор кафедры общей физики и молекулярной электроники физического факультета МГУ имени М.В. Ломоносова, г. Москва;
Скипетров Е.П., д.ф.-м.н., профессор кафедры физики низких температур и сверхпроводимости физического факультета МГУ имени М.В. Ломоносова, г. Москва.
Работа поступила в редакцию 22.02.2013.
Библиографическая ссылка
Кульбачинский В.А., Юзеева Н.А., Лунин Р.А., Овешников Л.Н. ВЛИЯНИЕ ВСТАВОК АРСЕНИДА ИНДИЯ НА ПОДВИЖНОСТИ ДВУМЕРНЫХ ЭЛЕКТРОНОВ В КВАНТОВЫХ ЯМАХ ИНДИЙ-ГАЛЛИЙ-МЫШЬЯК, ВЫРАЩЕННЫХ НА ПОДЛОЖКАХ ФОСФИДА ИНДИЯ // Фундаментальные исследования. – 2013. – № 4-4. – С. 853-857;URL: https://fundamental-research.ru/ru/article/view?id=31285 (дата обращения: 24.04.2024).



